高密度配線基板

CO2ガスレーザー穴あけ機、ビアフィル銅めっきライン、真空穴埋め機などの設備も保有しているため、ビルドアップ基板や貫通樹脂埋め基板のような高密度配線基板においても社内一貫製造が可能。もちろん、ほかの基板と同様、超短納期、高品質をお約束いたします。
- 特徴
- 近年は基板に搭載される部品の小型化、高密度実装化が著しく進んでおり、また基板自体にも5G等の次世代通信規格に代表される新技術への対応を求められております。その進歩は日々留まるところを知りません。このページで紹介する高難度基板は一般貫通基板と異なり、レーザービアや非貫通ドリルを用いることで貫通THによる配線制限を最小限におさえ、自由な配線設計を実現する事ができます。基板の軽薄短小化にも大いに役立っており、益々その必要性・需要が高まっております。
- 用途
- IoT製品、半導体パッケージ基板、デジタル家電、車載機器、産業機器、LED機器、モバイル機器、アンテナ/高周波部品/基地局向け、電源基板、計測用機器、アミューズメント機器、通信(5G)、ウェアラブルデバイス、大学研究向け、航空宇宙向け、医療機器向け 等

ビルドアップ基板
ビルドアップ構成の核となるコア層(2層貫通~多層貫通)を形成後、コア層から表層に向け1層ずつ絶縁層と導体層を逐次積層し、レーザーによる層間接続を行い多層化したプリント配線基板。層間接続にレーザービア(非貫通ビア)を用いることで自由な配線設計が可能で、近年益々その需要・用途が広まっております。またレーザービアは小径ですので、貫通樹脂埋めで対応出来ない狭ピッチBGA(0.3㎜ピッチ以下)等が搭載される基板においても使用されております。当社では多段ビルド(4段まで実績あります)、スタックトビア、フィルドビアめっき、すべてを社内一貫製造で対応しております。
※最短納期実績
4層(1-2-1)⇒3日目出荷
6層(2-2-2)⇒4日目出荷
(注)フィルドビア・スタック無しの場合
0.4㎜ピッチ256ピンBGA搭載
10層3-4-3ビルドアップ基板
(フィルドビア/スタックトビア仕様)
-

表面
-
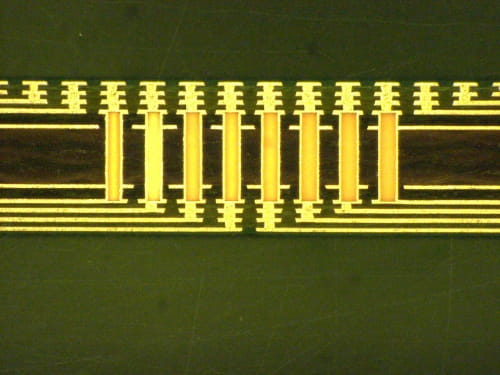
断面

構造
ビルドアップ基板 製造仕様例
当社で製造しているビルドアップ基板の製造仕様例です。掲載しているのは製作事例の一部ですので、まずはお気軽にお問い合わせください。
| 0.4㎜ピッチBGA搭載 10層 3-4-3ビルドアップ基板(フィルドビア/スタックトビア仕様) | |
|---|---|
| 板厚 | t1.6㎜ |
| BGAパッド径 | φ0.3㎜ |
| レジスト開口 | φ0.32㎜ |
| レーザー穴 径 |
φ0.1㎜ |
| 備考 | フィルドビアによるスタックトビア(ビアオンビア) コア部4層THは樹脂埋め/蓋めっき L5/6層クリアランスφ0.35㎜(THφ0.2㎜ドリル) |
| 0.3㎜ピッチBGA搭載 6層 2-2-2ビルドアップ基板(フィルドビア/スタックトビア仕様) | |
|---|---|
| 板厚 | t1.6㎜ |
| BGAパッド径 | φ0.22㎜ |
| レジスト開口 | φ0.24㎜ |
| レーザー穴径 | φ0.1㎜ |
| 備考 | フィルドビアによるスタックトビア(ビアオンビア) コア部THは樹脂埋め/蓋めっき コア部THφ0.2㎜ドリル/ランド径φ0.25㎜ |

貫通樹脂埋め基板
主に狭ピッチBGA(0.5~0.3㎜ピッチ等)部品が搭載される基板や、貫通TH(スルーホール)を埋める目的などで使用されているプリント基板。樹脂埋めしたい穴(1次TH)に永久穴埋め用インキ(エポキシ樹脂)を充填させた後、貫通TH(2次TH)を形成し、樹脂埋めを施した1次TH部分にも蓋めっきを形成することも可能です。層数は2層〜20層、板厚も3.2㎜まで樹脂埋めの実績があります。
※貫通樹脂埋め基板、狭ピッチBGA搭載例:0.4㎜ピッチ、0.3㎜ピッチ等
※最短納期実績 14層貫通樹脂埋め基板⇒2.1日出荷(16時データ⇒翌々日出荷)
0.5㎜ピッチBGA搭載 8層貫通樹脂埋め基板
-
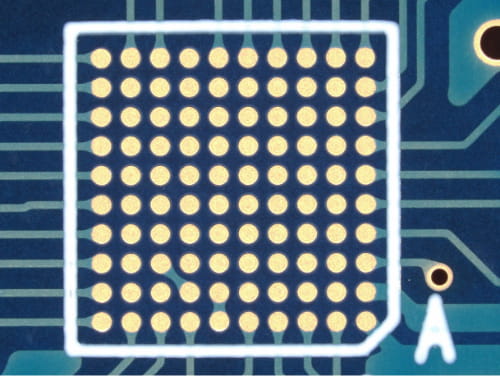
表面
-
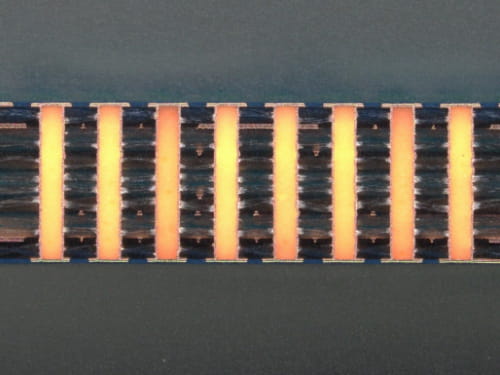
断面

構造
貫通樹脂埋め基板 製造仕様例
当社で製造している貫通樹脂埋め基板の製造仕様例です。掲載しているのは製作事例の一部ですので、まずはお気軽にお問い合わせください。
| 0.4㎜ピッチBGA搭載 12層貫通樹脂埋め基板 | |
|---|---|
| 板厚 | t1.6㎜ |
| BGAパッド径 | φ0.32㎜ |
| レジスト開口 | φ0.25㎜ |
| 樹脂埋めTHドリル | φ0.2㎜ |
| 備考 | 0.4㎜ピッチBGA部:内層穴ー穴間ライン0.05㎜ 0.4㎜ピッチBGA部:穴壁-内層ライン間隔0.075㎜ |

IVH基板
貫通ビアではなく、必要な層間のみを接続させ(非貫通ビア)、多層化したプリント基板。ビルドアップ基板と異なりレーザービアを用いておらず、層間接続の形成に全てNCドリルを使用しているのも特徴になります。多層基板に複数の非貫通穴で層間接続させることで、配線の自由度、配線密度の向上が実現されます。コア材(2層貫通~多層貫通)同士の張り合わせ、コア材(2層貫通~多層貫通)に導体層を順次積層する、BVH、COH等、松和産業ならば様々なIVH基板も製造可能です。
0.4㎜ピッチBGA搭載 8層6段連続IVH基板
-
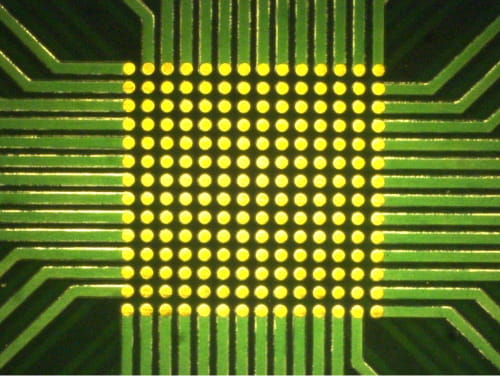
表面
-
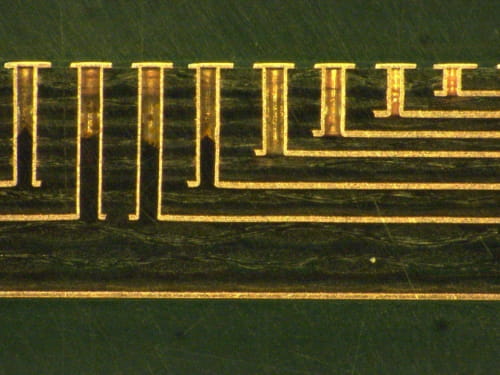
断面
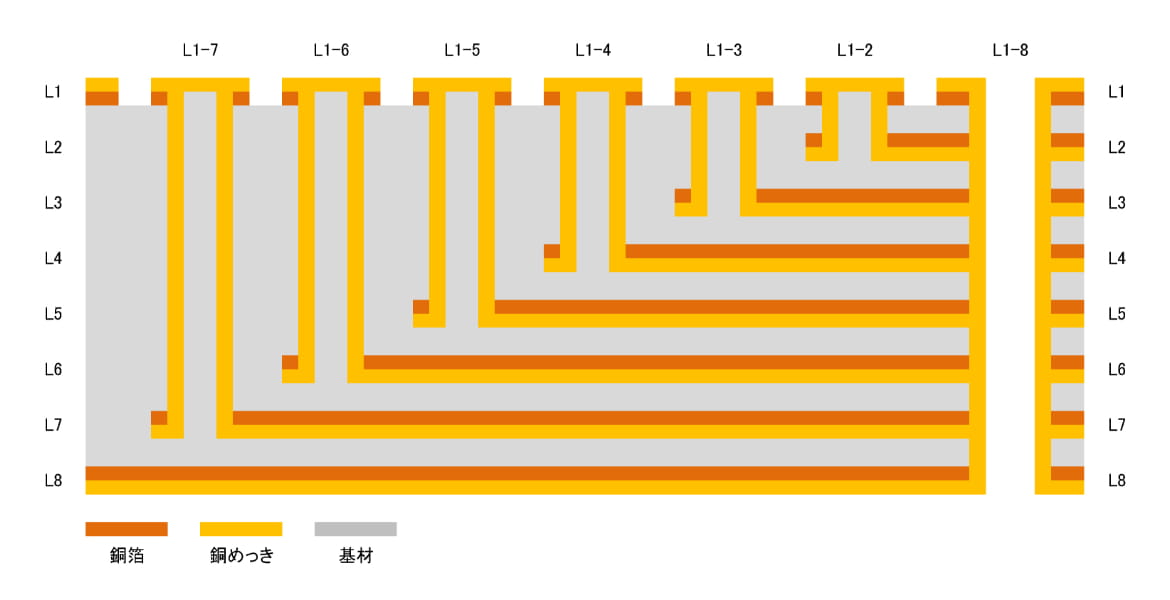
構造
IVH基板 製造仕様例
当社で製造しているIVH基板の製造仕様例です。掲載しているのは製作事例の一部ですので、まずはお気軽にお問い合わせください。
| 0.4㎜ピッチBGA搭載 8層6段連続IVH基板 | |
|---|---|
| IVH仕様 | L1-2/1-3/1-4/1-5/1-6/1-7IVH+L1-8貫通 |
| BGAパッド径 | φ0.3㎜ |
| 穴壁ーパターン間 | 0.175㎜ |
| IVHドリル径 | L1-2/L1-3=φ0.1㎜ L1-4〜L1-7=φ0.15㎜ |

エニーレイヤー基板
ビルドアップ基板と構成が若干異なり、内層コア部分においてもレーザービアを用い、全層レーザービア、フィルドビアメッキにより、基板の薄型化を可能としたプリント基板。配線の自由度は更に高まり、IOT製品、ウェアラブル製品、通信機器(5G)など、多くの製品に採用されています。
-
4層1-2-1ビルドアップ基板

断面
-
6層2-2-2ビルドアップ基板

断面

構造
エニーレイヤー基板
製造仕様例
当社で製造しているビルドアップ基板の製造仕様例です。掲載しているのは製作事例の一部ですので、まずはお気軽にお問い合わせください。
| 0.3㎜ピッチBGA搭載 6層2-2-2ビルドアップ基板(コアビアフィル/フィルドビア/スタックトビア仕様) | |
|---|---|
| 板厚 | t0.6㎜ |
| BGAパッド径 | φ0.24㎜ |
| レジスト開口 | φ0.17㎜ |
| レーザー穴径 | φ0.1㎜ |
| 備考 | コアビアフィルにるビアオンビア コア2層はレーザービア+フィルドビアメッキ L1/L2 フィルドビア+スタックトビア |
0.4㎜ピッチBGA部パッド間ライン通し
-
BGAピッチ 0.4㎜ パッド径 φ0.22㎜ レジスト開口 φ0.24㎜ L/S 0.06/0.06㎜ レジスト開口端⇔ライン間 0.05㎜ -
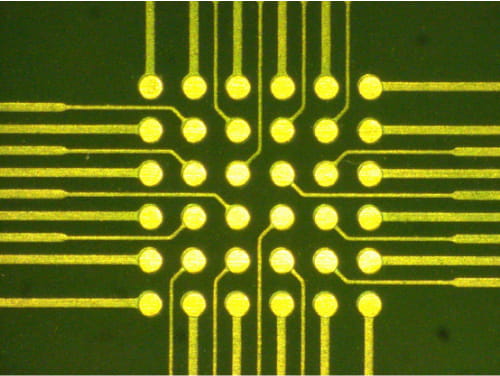
表面
